Resources
White Papers and Application Notes
三维集成电路中硅通孔的等效热模型
Published in 2018
三维封装技术是下一代集成电路最有潜力的发展方向。然而,由于三维封装结构的高度复杂性以及多尺度问题,若对所有细节进行建模,将会消耗巨大的计算资源,导致分析效率非常低下。例如,典型的硅通孔结构由圆柱型的金属导体以及外部包裹的一层非常薄的氧化层(微米级)所构成,使得三维封装整体结构的网格剖分非常稠密,严重影响求解效率。本文研究包含多个硅通孔的复杂结构热仿真问题。为了提高仿真效率,将含有薄氧化层的圆柱形硅通孔结构等效为不含氧化层的简化方柱结构。通过COMSOL软件的传热模块对简化方柱结构的等效热导率进行准确提取,包括水平方向和垂直方向的热导率参数。然后,基于上述等效模型,再用COMSOL软件对整体三维复杂结构进行建模仿真,可以极大降低软件的剖分单元和节点个数,从而显著提高整体的仿真效率。通过结果对比,发现简化模型能很好地保持仿真结果的分析精度。
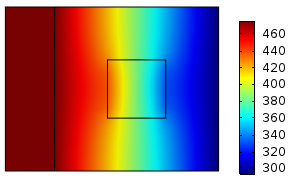
Download
- 唐_poster.pdf - 0.26MB
- 唐_abstract.pdf - 0.07MB
